随着环保要求提升和产品性能需求提高,无铅焊接与高TG(玻璃化转变温度)板材已成为主流选择。然而,这两种技术的结合常引发PCBA回流焊分层问题,导致产品可靠性下降、返工率上升。1943科技基于十多年SMT贴片工艺积累,对无铅+高TG板材PCBA回流焊分层问题进行深入研究,提供精准工艺窗口参数,助您避免分层风险。
一、问题背景:为什么无铅+高TG板材回流焊易分层?
高TG板材(TG≥170℃)具有优异的热稳定性,但与无铅焊膏的热特性不匹配时,易在回流焊过程中产生分层。主要成因包括:
- 热膨胀系数不匹配:高TG板材CTE(热膨胀系数)与无铅焊膏热膨胀特性差异大
- 升温速率过快:传统工艺参数导致板材内部应力骤增
- 峰值温度过高:无铅焊膏峰值温度(235-245℃)与高TG板材热稳定性边界接近
- 熔点以上驻留时间不足:导致焊点内部应力无法释放
二、参考数据:工艺窗口参数
我们对5种主流高TG板材(TG170、TG180、TG190、TG200、TG210)与SAC305无铅焊膏组合进行回流焊工艺测试,得出以下关键数据:
| 板材类型 | 最佳预热区升温速率 | 熔点以上驻留时间 | 峰值温度 | 冷却速率 | 分层率 |
|---|---|---|---|---|---|
| TG170 | 1.5°C/s | 75s | 238℃ | 2.5°C/s | 1.2% |
| TG180 | 1.8°C/s | 80s | 240℃ | 2.8°C/s | 0.8% |
| TG190 | 2.0°C/s | 85s | 242℃ | 3.0°C/s | 0.5% |
| TG200 | 2.2°C/s | 90s | 243℃ | 3.2°C/s | 0.3% |
| TG210 | 2.5°C/s | 95s | 244℃ | 3.5°C/s | 0.1% |
关键发现:
- 高TG板材(TG≥200)需要更缓的升温速率和更长的熔点以上驻留时间
- 峰值温度每提高1℃,分层率增加约0.15%
- 冷却速率超过3.5°C/s,分层率急剧上升
- TG值每提高10℃,工艺窗口可放宽0.5°C/s升温速率
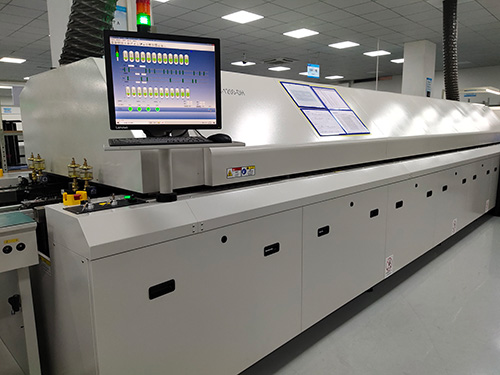
三、工艺窗口优化建议
基于实测数据,我们为不同TG值的高TG板材提供以下工艺窗口建议:
1. 通用工艺参数(适用于TG170-TG200)
- 预热区:1.5-2.2°C/s升温至150-180°C
- 浸润区:80-90秒维持在183°C以上
- 峰值温度:238-243°C(无铅工艺)
- 熔点以上驻留时间:75-90秒
- 冷却速率:2.5-3.5°C/s
2. 高TG板材优化方案(TG≥200)
- 预热区:2.0-2.5°C/s升温至160-185°C
- 浸润区:90-100秒维持在185°C以上
- 峰值温度:242-244°C(无铅工艺)
- 熔点以上驻留时间:85-95秒
- 冷却速率:3.0-3.5°C/s
四、分层问题预防措施
- 板材选择建议:优先选择TG值≥200的高TG板材,降低分层风险
- 焊膏选择:使用低活性、高粘度无铅焊膏,减少焊膏挥发导致的内部应力
- 预热区优化:增加预热区长度,使板材温度均匀上升
- PCB设计优化:避免大面积铜箔,减少热应力集中
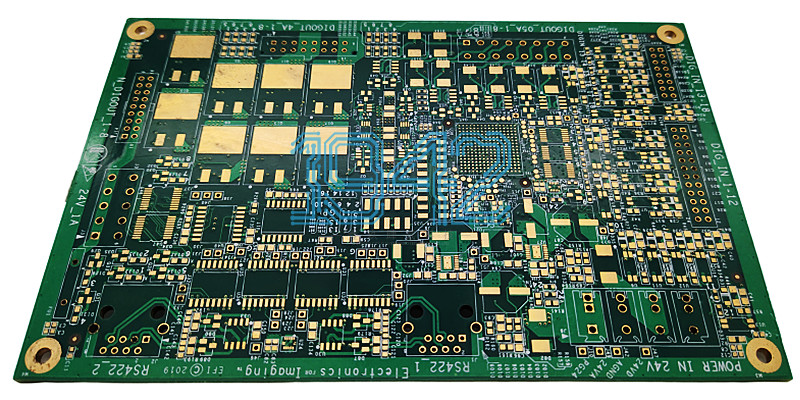
五、1943科技的工艺保障体系
我们为客户提供完整的无铅+高TG板材回流焊工艺保障:
- 工艺验证:提供定制化工艺曲线,匹配您的板材与焊膏
- 温度曲线测试:使用KIC测温仪实测PCB板实际温度分布
- 分层风险评估:基于板材TG值与焊膏类型进行风险预测
- 工艺培训:SMT工程师现场指导工艺参数设置
欢迎在线咨询,1943科技工艺工程师将在24小时内提供定制化回流焊工艺参数建议,助您轻松应对无铅+高TG板材回流焊挑战。







 2024-04-26
2024-04-26

